
半導體市場提前破兆美元!「美國設計、亞洲製造」成形 3大技術並進
...達3,999億元、年增高達116%。彭茂榮指出,高頻寬記憶體(HBM)已成為AI運算關鍵元件,隨著H...

...達3,999億元、年增高達116%。彭茂榮指出,高頻寬記憶體(HBM)已成為AI運算關鍵元件,隨著H...

...討論也從GPU、token、電力延伸至記憶體、網路頻寬與用水等,顯示產業鏈需求全面爆發。這些瓶頸某種...

... TOPS全模態AI算力,並透過演算法優化將大模型頻寬壓縮至10%,大幅提升推論效率。同時支援多程序...

...。隨著JEDEC持續推動HBM技術藍圖,HBM4在頻寬與容量上大幅提升,資料匯流排寬度也進一步倍增。...

...S封裝預計擴展至14倍光罩尺寸以上,以因應AI對高頻寬記憶體與運算整合需求;SoIC與COUPE(共...

...寸的CoWoS可整合約10個大型運算晶粒與20個高頻寬記憶體(HBM)堆疊,預計於2028年開始生產...

...他進一步說明,記憶體技術已從傳統DDR世代演進至高頻寬記憶體(HBM)等新架構,產業不再只是線性升級...

...支出方面,力積電表示,隨著美光交易案推進,並因應高頻寬記憶體(HBM)後段製造布局,今年資本支出規劃...

...CPO的第一動機。 同時,未來Feynman世代頻寬將由100G PAM4提升至200G甚至400...

...製作,並預計生產邊緣推論處理器、衛星抗輻射晶片及高頻寬記憶體(HBM)。為了達成2029年投產的目標...

根據Nielsen law推估,全球寬頻頻寬約每7年成長10倍。凱擘大寬頻2012年推出100M服務...
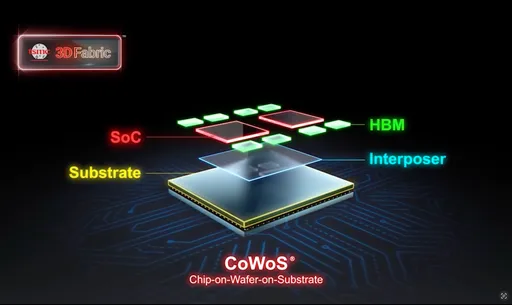
...用於高階AI晶片。在AI模型規模與整合度提升下,高頻寬與大尺寸封裝需求快速成長,帶動CoWoS需求持...

...AI模型規模擴大與晶片整合度提升,市場對大尺寸與高頻寬封裝需求快速增加,帶動CoWoS需求持續爆發。...

...AI模型規模擴大與晶片整合度提升,客戶對大尺寸與高頻寬封裝需求快速增加,帶動CoWoS需求持續爆發。...

...建設浪潮下,半導體已成為全球戰略物資,先進晶片與高頻寬記憶體產能正被科技巨頭積極布局,供應缺口延續時...

...Calderoni表示,邏輯運算成長速度遠超記憶體頻寬,需透過3D整合與異質封裝技術發展HBM,以提...

【記者呂承哲/台北報導】全球晶圓代工龍頭台積電(2330)法說會將於週四(16日)登場,市場除關注2奈米製程與整體營運表現外,先進封裝技術發展亦成為另一大焦點,包括CoPoS(面板級封裝)與COUPE(矽光子CPO封裝)等技術仍處於驗證與測試階段,距離真正放量仍需時間,發展節奏將牽動未來AI供應鏈布局。
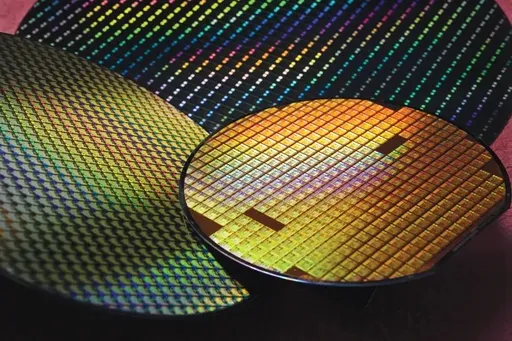
...。 後段製程設備則展現更強勁成長。隨AI應用與高頻寬記憶體(HBM)對效能與測試需求提升,測試設備...

...e平台打造具成本效益且可擴展的車用運算架構。透過高頻寬與強大運算能力,系統可整合多元感測技術,建構3...

...rosoft與OpenAI等科技公司,都積極採購高頻寬記憶體(HBM)晶片,用於AI資料中心,帶動三...