
台積電先進封裝升級!COUPE今年生產 CoWoS衝14倍光罩、SoW-X接棒
【記者呂承哲/台北報導】全球晶圓代工龍頭台積電(2330)於美國當地時間22日舉辦2026年北美技術論壇,市場關注台積電在先進封裝領域的進展。台積電宣布,在3DFabric先進封裝及3D矽堆疊方面,為支持人工智慧(AI)對單一封裝中更高運算能力及記憶體的需求,持續擴展其CoWoS技術,以整合更多矽晶。

【記者呂承哲/台北報導】全球晶圓代工龍頭台積電(2330)於美國當地時間22日舉辦2026年北美技術論壇,市場關注台積電在先進封裝領域的進展。台積電宣布,在3DFabric先進封裝及3D矽堆疊方面,為支持人工智慧(AI)對單一封裝中更高運算能力及記憶體的需求,持續擴展其CoWoS技術,以整合更多矽晶。

...計、IP、封裝與材料等合作夥伴,建立完整生態系,為3D堆疊與異質整合奠定基礎。 隨著AI晶片需求暴...

...AP)晶圓測試卡供應能力的業者。近年隨著製程微縮、3D堆疊與異質整合等先進封裝技術發展,公司技術版圖...

...以硬體組裝為主的設備廠不同。隨著製程持續微縮,以及3D堆疊與先進封裝技術快速發展,單純依賴傳統光學檢...

...端最直接受惠者仍為三星與SK海力士。 HBM透過3D堆疊與TSV技術縮短資料傳輸距離,是AI硬體的...

...寸也持續放大,未來可能達1萬至2萬平方毫米,並結合3D堆疊與強化散熱、供電技術,以支撐高功耗AI晶片...
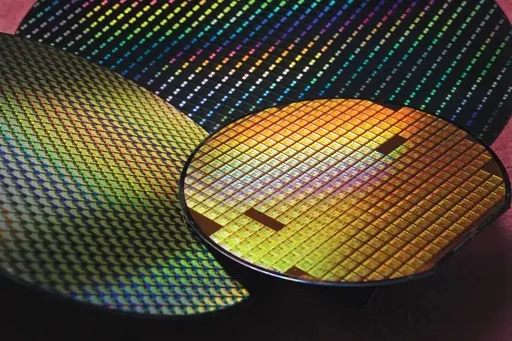
【記者呂承哲/台北報導】隨全球AI應用逐步邁向商用化,科技產業景氣持續回溫,帶動半導體相關類股表現強勁。晶圓代工龍頭台積電日前於法說會釋出強勁資本支出規劃與樂觀展望,不僅推升股價再創新高,也為即將登場的美股超級財報週提前暖身。

...略儲備」。 在技術層面,先進封裝成為新競爭焦點。3D堆疊、小晶片與光子技術帶動材料創新,材料科學的...

【記者呂承哲/台北報導】G2C 聯盟成員、半導體設備供應商均豪精密(5443)、均華精密(6640)今(11)日於櫃買中心舉行業績發表會後接受法人提問。均華董事長梁又文直言,CoWoS 只是起點,產業正邁向 Beyond CoWoS 的 3D IC 堆疊新時代;總經理石敦智則點出公司四大成長動能,說明本土設備廠在國際化、在地化浪潮下的關鍵角色。

【記者呂承哲/台北報導】荷蘭半導體設備大廠 ASML 今(19)日舉行媒體科技教育交流會,由 ASML 台灣暨東南亞區客戶行銷主管徐寬成說明 AI 帶動的全球半導體發展。他強調,AI 正成為下一波半導體強勁成長引擎,並指出「摩爾定律已死」說法並不正確,未來十多年仍會沿著微縮路線持續推進, ASML 產品線正是支撐這股動力的核心。

【記者呂承哲/台北報導】西門子數位工業軟體宣布推出全新 Tessent IJTAG Pro,透過將原本串列架構轉為平行運作,全面革新基於 IEEE 1687 的 IJTAG 測試流程。新方案支援高頻寬內部 JTAG(IJTAG)與資料串流功能,並整合西門子 Tessent 串流掃描網路(SSN)寬匯流排架構,大幅提升資料傳輸速度,有助降低測試成本、縮短測試時間。

【記者呂承哲/台北報導】在全球AI浪潮強勢推動下,半導體產業正邁向全新階段。工研院今(28)日下午舉辦「眺望2026產業發展趨勢研討會」半導體場次,聚焦IC設計、先進封裝與製造技術的最新發展趨勢,剖析台灣如何掌握AI時代產業轉型與成長契機。工研院指出,台灣身為全球半導體核心樞紐,面對AI與創新應用推進,IC設計、製造與封測三大領域都展現強勁成長動能,產業正穩步挺進新一波長期擴張期。

【記者呂承哲/台北報導】英特爾(Intel)9日揭露新一代客戶端處理器 Intel Core Ultra 系列3(代號 Panther Lake)架構細節,該產品為英特爾首款採用 Intel 18A 製程技術的處理器,預計今年底開始出貨。這項先進製程完全於美國研發與製造,象徵美國在半導體製造領域的技術領導地位再下一城。

...將延伸至晶圓級封裝(WLP)、多晶片模組(MCM)3D堆疊與面板級封裝(PLP),都將成為台灣供應鏈...

...將貢獻營收。同時,聯電持續強化先進封裝布局,鎖定2.5D與3D堆疊應用,積極搶攻雲端與邊緣AI市場。

【記者呂承哲/台北報導】半導體設備大廠 Lam Research(科林研發)今(10)日正式發表全新沉積設備 VECTOR TEOS 3D,鎖定次世代人工智慧(AI)及高效能運算(HPC)所需的先進封裝應用。該設備聚焦於解決 3D 堆疊與高密度異質整合製程的關鍵難題,透過專有翹曲晶圓傳送方案與介電沉積技術,實現超厚且均勻的晶片間介電層填充。搭配 Lam Research 的 Equipment Intelligence 技術,更能提升製程監控能力。目前 TEOS 3D 已在全球頂尖邏輯與記憶體晶圓廠投入使用,象徵先進封裝製程邁入新里程碑。

...備承接國際訂單的潛力,後續也可能擴展至晶圓級封裝與3D堆疊,但真正新一波投資週期可能要到2027年之...

...價值取決於人類使用情境與地球永續需求。他以矽光子與3D堆疊比喻都市交通,指出當銅線遇到瓶頸,就需要「...

...將貢獻營收。同時,聯電持續強化先進封裝布局,鎖定2.5D與3D堆疊應用,積極搶攻雲端與邊緣AI市場。

...將貢獻營收。同時,聯電持續強化先進封裝布局,鎖定2.5D與3D堆疊應用,積極搶攻雲端與邊緣AI市場。